삼성전자, 첨단 D램 기술력…수율 안정이 관건
SK하이닉스, 이전 세대 활용…TSMC에 주문도

(문화뉴스 이기철 기자) 인공지능(AI) 시대를 맞아 AI 반도체의 성능이 6세대 고대역폭메모리(HBM)인 ‘HBM4’가 결정적인 것으로 전망된다. 이에 따라 메모리 기업들의 전쟁터는 HBM4 성능 향상이다. 이들의 주요 무기는 D램 제조공정, 패키징, 베이스(로직) 다이 등이다.
3일 업계에 따르면 본격적인 6세대 'HBM4' 양산을 앞둔 메모리 업계는 제품 성능 향상에 집중하고 있다. 6세대는 첨단기술의 정수이자 물리적 한계로 꼽힌다. HBM4의 적층 단수는 기존 '최대 12단'에서 '최대 16단'으로 높아진다. 개당 최대 용량도 36GB에서 48GB로 확장된다.
'HBM3 뒷북' 삼성전자는 최신 D램 기술력에 사활을 걸고 있다. 삼성전자는 메모리 3사 가운데 유일하게 HBM4를 '10나노급 6세대(1c) D램'으로 만든다. 1c는 최신 D램 기술로, 선폭이 가장 미세해 기존 1b 공정보다 더 많은 회로를 넣을 수 있다. 이는 데이터를 더 빠르게 처리하고, 전력은 더 적게 쓴다는 말이다.
삼성전자는 최첨단 D램 기술을 쓰는 만큼 공정 자체가 불안할 수 있다는 것이 단점이다. 수율(양품비율)이 기존에 쓰이던 1b 공정에 비해 낮아지면 단가가 올라 수익성이 떨어지게 된다.
SK하이닉스는 마이크론과 마찬가지로 HBM4 양산에 이전 세대인 1b 공정을 활용하지만 '패키징'에서 강점을 가진다. HBM은 여러 개의 D램을 쌓아 만들어야 하는데, 안정적으로 D램을 이어 붙이는 과정이 패키징이다. 패키징도 HBM의 성능 향상에 크게 도움된다.
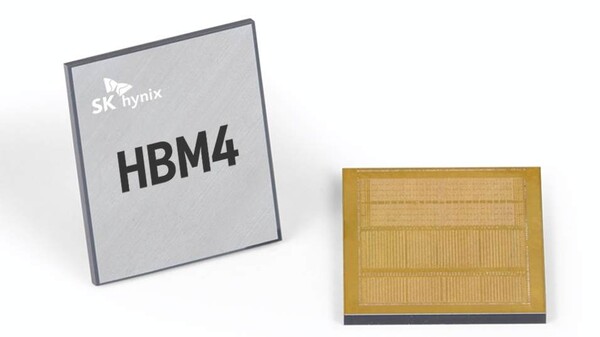
SK하이닉스는 독자 패키징 기술인 '매스리플로우-몰디드 언더필(MR-MUF)'을 HBM4에 활용하는 것으로 알려졌다. 양산 과정에서 리스크를 최소화하면서도 HBM3E와 같이 높은 성능을 구현하겠다는 것이다.
HBM4부터는 '고객 맞춤형(커스터마이즈드) 칩이어서 베이스(로직) 다이의 역할이 중요하다. 이에 SK하이닉스는 대만의 TSMC에 이를 주문할 방침이다. HBM은 두뇌 역할을 하는 다이 위에 D램을 쌓아 만드는 '코어 다이'로 구성된다. 베이스 다이는 GPU(그래픽처리장치)와 연결해주는 역할을 한다.
반면 삼성전자는 자체 파운드리를 통해 HBM4 베이스 다이를 생산한다.
미국 마이크론도 베이스 다이와 D램을 자체 기술력으로 만들고 있다. 마이크론은 자체 베이스 다이 사용에 대해 "성능과 전력 효율면에서 업계 최고 수준의 성능이라는 측면에서 독보적인 우위를 제공할 것"이라고 밝혔다. 마이크론은 2027년 생산 예정인 7세대 제품인 'HBM4E'에서는 TSMC와 협력해 성능 개선을 추진할 예정이다.
업계 관계자는 “HBM4는 단순한 메모리 기술을 넘어 솔루션으로 진화 과정”이라며 "HBM4부터 D램 공정, 패키징 등 종합적인 역량이 뒷받침돼야 성능이 극대화된다"라고 말했다.
문화뉴스 / 이기철 기자 leekic2@gmail.com

